秒懂半导体封装技术——银烧结技术
随着新一代功率半导体芯片及功率密度的进一步提高,对功率电子模块及其封装工艺要求也越来越高,特别是芯片与基板的互连技术很大程度上决定了功率模块的寿命和可靠性。传统钎焊料熔点低、导热性差,难以满足高功率器件封装及其高温应用要求。此外随着第三代半导体器件(如碳化硅和氮化镓等)的快速发展,对封装的性能方面提出了更为严苛的要求。银烧结技术是一种新型的高可靠性连接技术,在功率模块封装中的应用受到越来越多的关注。
银烧结技术的优势特点
1.什么是银烧结技术
20世纪80年代末期,Scheuermann等研究了一种低温烧结技术,即通过银烧结银颗粒实现功率半导体器件与基板的互连方法。
银烧结技术也被成为低温连接技术(Low temperature joining technique, LTJT),作为一种新型无铅化芯片互连技术,可在低温(<250℃)条件下获得耐高温(>700℃)和高导热率(~240 W/m·K)的烧结银芯片连接界面,具有以下几方面优势:
①烧结连接层成分为银,具有优异的导电和导热性能;
②由于银的熔点高达(961℃),将不会产生熔点小于300℃的软钎焊连接层中出现的典型疲劳效应,具有极高的可靠性;
③所用烧结材料具有和传统软钎焊料相近的烧结温度;
④烧结材料不含铅,属于环境友好型材料。
相对于焊料合金,银烧结技术可以更有效的提高大功率硅基IGBT模块的工作环境温度及使用寿命。目前,银烧结技术已受到高温功率电子领域的广泛关注,它特别适合作为高温SiC器件等宽禁带半导体功率模块的芯片互连界面材料。
2.银烧结技术原理
银烧结技术是一种对微米级及以下的银颗粒在300℃以下进行烧结,通过原子间的扩散从而实现良好连接的技术。所用的烧结材料的基本成分是银颗粒,根据状态不同,烧结材料一般为银浆(银膏)、银膜,对应的工艺也不同:
银浆工艺流程:银浆印刷——预热烘烤——芯片贴片——加压烧结;
银膜工艺流程: 芯片转印——芯片贴片——加压烧结。
芯片转印是指将芯片在银膜上压一下,利用芯片锐利的边缘,在银膜上切出一个相同面积的银膜并粘连到芯片背面。
以纳米银浆为例,在烧结过程中,银颗粒通过接触形成烧结颈,银原子通过扩散迁移到烧结颈区域,从而烧结颈不断长大,相邻银颗粒之间的距离逐渐缩小,形成连续的孔隙网络,随着烧结过程的进行,孔洞逐渐变小,烧结密度和强度显著增加,在烧结最后阶段,多数孔洞被完全分割,小孔洞逐渐消失,大空洞逐渐变小,直到达到最终的致密度。
烧结得到的连接层为多孔性结构,孔洞尺寸在微米及亚微米级别,连接层具有良好的导热和导电性能,热匹配性能良好。
二
银烧结技术在功率模块封装的应用
作为高可靠性芯片连接技术,银烧结技术得到了功率模块厂商的广泛重视,一些功率半导体头部公司相继推出类似技术,已在功率模块的封装中取得了应用。
如今,银烧结技术已经成为宽禁带半导体功率模块必不可少的技术之一,随着宽禁带半导体材料(SiC、GaN)的发展,银烧结技术将拥有良好的应用前景。
三
银烧结技术在其他领域的应用
银烧结技术不仅在功率半导体封装领域得到了广泛应用,还可以应用于其他领域,如汽车电子、航空航天、LED照明等领域。
汽车电子:随着新能源汽车的发展,电动汽车对高效率、高可靠性的电力电子器件的需求不断增加。银烧结技术可以提高功率器件的稳定性和可靠性,满足电动汽车对电力电子器件的严苛要求。
航空航天:航空航天领域对电子器件的工作温度、可靠性和耐久性有极高的要求。采用银
烧结技术的电子器件可以在极端温度环境下稳定工作,具有更长的使用寿命,因此在航空航天领域有着广泛的应用前景。
LED照明:LED照明设备对导热性能有很高的要求,因为高效的导热可以降低LED芯片的工作温度,从而延长其使用寿命。银烧结技术具有优异的导热性能,可以有效提高LED照明设备的散热效果和使用寿命。
微波器件:在高频微波器件中,由于银烧结技术具有良好的导电性和导热性,因此可以提高微波器件的工作效率和可靠性。
四
银烧结技术的挑战与发展趋势
尽管银烧结技术在功率电子领域及其他应用领域展现出诸多优势,但仍面临一些挑战和问题,需要不断研究和改进。
设备成本:银烧结技术所需的设备和材料成本较高,这对于大规模推广和应用产生一定阻碍。未来需要在降低成本和提高生产效率方面取得突破。
工艺控制:银烧结工艺参数对互连层的性能有很大影响,因此对工艺参数的控制非常关键。进一步研究和优化工艺参数,提高银烧结连接层的性能和可靠性是未来发展的重点。
环境稳定性:银烧结连接层可能受到外部环境因素的影响,如湿度、氧化等,影响其长期稳定性。因此,未来需要研究改进烧结材料的环境稳定性,以适应更广泛的应用需求。

五
碳化硅半导体封装银烧结技术分析
碳化硅芯片可在300℃以上稳定工作,预计模块结温将达到175-200℃。传统功率模块中,芯片通过软钎焊接到基板上,连接界面一般为两相或三相合金系统,在温度变化过程中,连接界面通过形成金属化合物层使芯片、软钎焊料合金及基板之间形成互联。
目前电子封装中常用的软钎焊料为含铅钎料或无铅钎料,其熔点基本在300℃以下,采用软钎焊工艺的功率模块结温一般低于150℃,当应用于温度为175-200℃甚至200℃以上的情况时,其连接层性能会急剧退化,影响模块工作的可靠性。根据RoHS指令要求,由于铅具有毒性,会对环境和人体健康产生危害,已在电子产品中禁止使用含铅钎料。
银烧结技术也被称为低温连接技术,是最为适合于宽禁半导体模块封装的界面连接技术之一,是碳化硅模块封装中的关键技术,也是目前应用最为广泛的技术。与传统连接方式相比,银烧结技术具有以下几方面的优势:烧结连接层成分为银,具有优异的导电和导热性能;由于银的熔点高达961℃,将不会产生熔点小于300℃的软钎焊连接层中出现的典型疲劳效应,具有极高的可靠性;所用烧结材料具有和传统软钎焊料相近的烧结温度;烧结料不含铅,属于环境友好型材料。
芯片与基板的耐高温、低成本连接技术和可靠性的问题是目前第三代半导体材料模块封装的关键技术。
我国第三代半导体模块耐高温连接技术以高温无铅钎料封装连接为主,主要的钎料有锌基高温钎料、金基高温钎料、Bi-Ag基钎料和Sn-Sb基钎料。高温无铅钎料虽然制备工艺简单,适应性强,但连接温度高于使用温度,热稳定性差,同时高温钎料的工艺特性(润湿性)与力学性能(强度)、物理性能(导热性与导电性)、热稳定性难以兼顾。国内使用高温无铅钎料主要为SnAg(96.5:3.5)和SnAgCu(96.5:3:0.5),熔点为221℃和217℃。
国内通过提高钎料本身的耐高温能力来提升钎焊接头的耐温能力,从而解决高温功率器件封装问题是困难的,目前国内开发的高温无铅钎料使用温度均不超过350℃,这与新一代功率芯片所能达到的工作温度500-1000℃相比差距较大。
国外研究的第三代半导体连接技术有银低温烧结连接技术、固液互扩散连接(SLD)和瞬时液相烧结连接(TLPS),其中银烧结技术是目前国外第三代半导体封装技术中发展最为成熟、应用最为广泛的技术,美国、日本等碳化硅模块生产企业均采用此技术。与高温无铅钎料相比,银烧结技术烧结连接层成分为银,具有优异的导电和导热性能,由于银的熔点高达961℃,将不会产生熔点小于300℃的软钎焊连层中出现的典型疲劳效应,具有极高的可靠性,且其烧结温度和传统软钎焊料温度相当。
相比焊接模块,银烧结技术对模组结构、使用寿命、散热产生了重要影响,采用银烧结技术可使模块使用寿命提高5-10倍,烧结层厚度较焊接层厚度薄60-70%,热传导率提升3倍,国外厂商把银烧结技术作为第三代半导体封装的核心技术,银烧结技术成为芯片与基板之间连接的不二选择,同时在此基础上开发出双面银烧结技术,将银带烧结在芯片正面代替了铝线,或取消底板将基板直接烧结在散热器上,大大简化了模块封装的结构。
国外银烧结技术已经由微米银烧结进入纳米银烧结阶段,纳米银烧结与微米银烧结技术相比连接温度和辅助压力均有明显下降,极大扩大了工艺的使用范围。在银烧结技术中,为了防止氧化和提高氧化层的可靠性,需要在基板裸铜表面先镀镍再镀金或镀银,同时烧结温度控制和压力控制也是影响模组质量的关键因素。
银烧结技术在国外发展遇到的主要问题是:银烧结技术所用的银浆成本远高于焊膏,银浆成本随着银颗粒尺寸的减小而增加,同时基板铜层的贵金属镀层也增加了成本;银烧结技术需要一定的辅助压力,高辅助压力易造成芯片的损伤;银烧结预热、烧结整个过程长达60分钟以上,生产效率较低;银烧结技术得到的连接层,其内部空洞一般在微米或者亚微米级别,目前尚无有效的检测方法。
六
总结
银烧结技术作为一种高可靠性连接技术,在功率模块封装及其他领域的应用受到越来越多的关注。随着新一代功率半导体芯片及功率密度的不断提高,对电子器件性能的要求越来越高。银烧结技术可以有效提高功率模块的寿命和可靠性,满足高功率器件封装及其高温应用要求。然而,银烧结技术在成本、工艺控制和环境稳定性方面仍面临挑战,需要持续研究和改进。在未来,随着第三代半导体器件(如碳化硅和氮化镓等)的快速发展,银烧结技术将在电力电子、汽车、航空航天、LED照明以及微波器件等领域发挥更大的作用。
为了克服银烧结技术的挑战和发展趋势,研究人员和企业正致力于以下方面的工作:
材料创新:研究和开发新型烧结材料,提高其性能和稳定性,降低成本,以满足不同领域的应用需求。
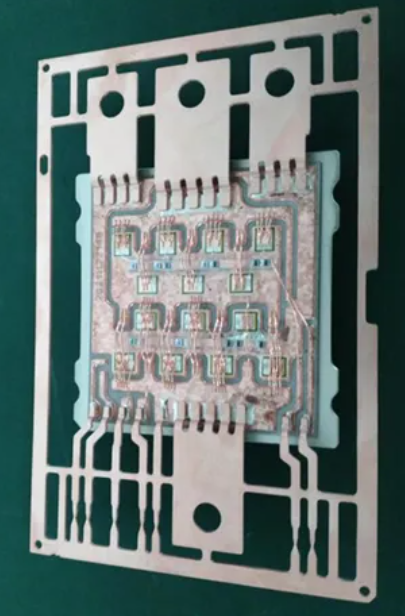
银烧结的模块
工艺优化:优化银烧结工艺参数,提高互连层的性能和可靠性,降低制程复杂度和成本。
设备发展:研究和开发更高效、可靠的银烧结设备,提高生产效率,降低生产成本,为银烧结技术的大规模应用奠定基础。目前国内中科同志的银烧结设备已经在客户现场使用一年多,完成工艺验证、材料验证、良率提升等等方面的节点,获得了国内几家大客户的认可。目前正在推荐年产30-60万个SIC模块的生产线整体解决方案。
标准化:制定银烧结技术的标准和规范,推动银烧结技术在各领域的广泛应用和发展。
跨领域合作:加强学术界、企业和产业界之间的交流与合作,共同推动银烧结技术的研究、发展和应用。
随着银烧结技术的进一步研究和发展,它将在各种应用领域发挥越来越重要的作用,为解决高功率器件封装及其高温应用要求提供更优质的技术支持。相信在不久的将来,银烧结技术将在功率电子及其他相关领域取得更大的突破和应用。

